晶圆键合是一种晶圆级封装技术,用于制造微机电系统 (MEMS)、纳米机电系统 (NEMS)、微电子学和光电子学,确保机械稳定和气密密封。用于 MEMS/NEMS 的晶圆直径范围为 100 毫米至 200 毫米(4 英寸至 8 英寸),用于生产微电子器件的晶圆直径最大为 300 毫米(12 英寸)。
在微纳加工 (MEMS / NEMS) 中,封装可保护敏感的内部结构免受温度、湿度、高压和氧化物质等环境影响。内部功能元器件的长期稳定性和可靠性取决于封装工艺,这部分封装工艺也占了整体成本的很大比重。比如 MEMS压力传感器 的加工中就会涉及到晶圆键合这个工艺步骤。

图1-压力传感器加工中的键合工艺
晶圆键合需要特定的环境条件等参数,通常有下面几项变量:
基材表面
平整度
清洁度
键合环境(温度、压力)
施加的力
实际的键合效果会受到这些变量的相互作用影响。因此,需要根据当前晶圆基材和键合的规格定义来选择相应的参数。
此外,为了评估键合工艺的产量、强度和气密性水平,还需要对键合晶圆进行表征,一般的表征方法有:
破坏性技术,例如对键合以后的晶圆进行拉伸或剪切测试
非破坏性技术,例如用光学方法来发现裂纹或界面空隙,以评估粘合强度
非破坏性技术,还可以某些气体、液体进行填充,用于气密性测试
键合工艺可以细分为如下几种技术:
直接键合(Direct bonding)
表面活化键合(Surface activated bonding)
等离子激活键合(Plasma activated bonding)
阳极键合(Anodic bonding)
共晶键合(Eutectic bonding)
玻璃熔块键合(Glass frit bonding)
粘接(Adhesive bonding)
热压键合(Thermocompression bonding)
反应键合(Reactive bonding)
瞬态液相扩散键合(Transient liquid phase diffusion bonding)
原子扩散键合(Atomic diffusion bonding)
临时键合(Temporal Silicon Bonding)
我们主要介绍其中三种:直接键合(Direct bonding)、阳极键合(Anodic bonding)、共晶键合(Eutectic bonding)。
直接键合(Direct bonding)
硅直接键合,也称为硅熔合键合,是一种能够牢固地连接两个硅片的工艺,主要利用机械力和高于700摄氏度的高温将两个硅片键合在一起。
它的出现是 20 世纪 80 年代高频和抗辐射 CMOS 应用 SOI 技术发展的重要一步。这一概念在后来扩展到压力传感器和加速度计的制造,现在已成为 MEMS 工具箱中的一项重要技术。

图2-SOI晶圆中的键合
硅直接键合可以在两个裸露的单晶硅表面或抛光的多晶硅之间进行。为了实现均匀且无空隙的键合,表面必须没有颗粒和化学污染,如在 100 毫米晶圆上平坦度在 5 μm 以内。具体的键合过程从对硅片表面进行清洁和水合开始。以下是典型的顺序:
首先,在热 Piranha(硫酸和过氧化氢)溶液中对晶圆进行预清洗。
将它们浸入稀释的 HF 溶液中,蚀刻掉天然氧化物(或热氧化物表面)并去除氧化物中捕获的污染物。
进行 RCA-1 清洁(热氢氧化铵和过氧化氢溶液)清洁,旨在去除有机物。
进行 RCA-2 清洁(热盐酸和过氧化氢溶液)以去除金属污染物。所有热的过氧化氢溶液都会在表面形成键合所需的羟基 (-OH)。这称为水合作用。
小心地使粘合表面接触并通过范德华力保持在一起。
根据反应,在 800° 至 1,100°C 下退火几个小时可促进并强化结合。

图3-直接键合流程
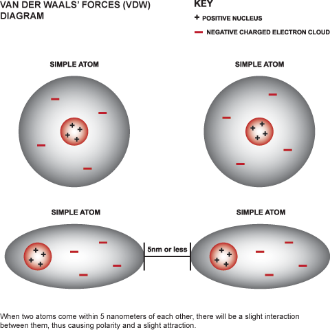
图4-范德华力 Van Der Waals forces
当然,实际键合过程中,分子间相互作用有多种,范德华力是其中之一,其他还有氢键和共价键。
在某些情况下,两个硅片表面上的图形化特征必须在键合之前彼此对准。例如,一个硅片中的空腔需要对接连接到第二个硅片提供的入口。这需要特殊设备来执行对准和键合,SÜSS MicroTec 和 EV Group 这两家设备制造商就有类似的技术方案,大体过程是:
将晶圆依次安装在特殊的机械夹具中,并以类似于光刻中双面对准的方式与彼此面对的两个键合表面对准。
机械夹具将对齐的晶圆固定到位,晶圆边缘由薄垫片隔开。
使晶圆的中心接触并去除间隔物,使键合区域从晶圆中心延伸到边缘。对准的相对错位通常小于 5 μm,最高可达 1 μm。

图5-EV Group的键合机台
阳极键合(Anodic bonding)
阳极键合,是一种将硅片和含钠玻璃基板(例如 Borofloat 33)连接在一起的键合工艺。它用于制造各种传感器,为硅片提供了刚性支撑。
键合过程在真空、空气或惰性气体环境中、在200°C至500°C之间的温度下进行。在两个基板上施加 500 至 1,500V 的电压,同时玻璃保持在负电势,导致玻璃中的移动正离子(主要是 Na + )从硅-玻璃界面向阴极迁移,留下固定的负离子。玻璃中固定的负离子与硅片的正电荷之间的静电引力将两个基板固定在一起,并促进玻璃与硅的化学键合。当离子电流(在外部测量为电子电流)消失时,键合完成,表明所有移动离子已到达阴极。

图6-玻璃和硅之间的阳极键合示意图
玻璃基板的热膨胀系数优选与硅的热膨胀系数匹配,以便最小化热应力。
共晶键合(Eutectic bonding)
共晶键合,也称为共晶焊接,是两种或多种金属的组合允许在特定温度下直接从固态转变为液态。共晶温度远低于键合过程中涉及的材料的熔化温度。共晶键合广泛用于 MEMS 行业的气密密封、压力或真空封装。
共晶键合中最常用的金属/合金是 Al-Ge、Au-Sn 和 Au-In,还有许多其他材料组合可以产生共晶键合系统。此外,硅与金等金属形成合金的能力也可以成为共晶键合的基础。所有共晶键必须经过液相,因此对表面平整度不规则性、划痕和颗粒不太敏感,从而有利于大批量生产。
键合温度、时间和压力是共晶键合最重要的参数,共晶键合可以在较低的加工温度和最小的合成应力下实现高键合强度。共晶键合还可在单一工艺中实现气密密封和电气互连。与其他中间层(例如粘合剂或玻璃料)相比,共晶键合还可以促进更好的排气和气密性。

图7-GaAs/InP 晶圆中的 Au-Sn 共晶金属键合
(源自EVG官网)
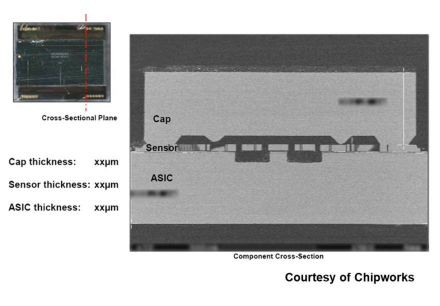
图8-MEMS/ASIS 晶圆中的 Al-Ge 共晶键合